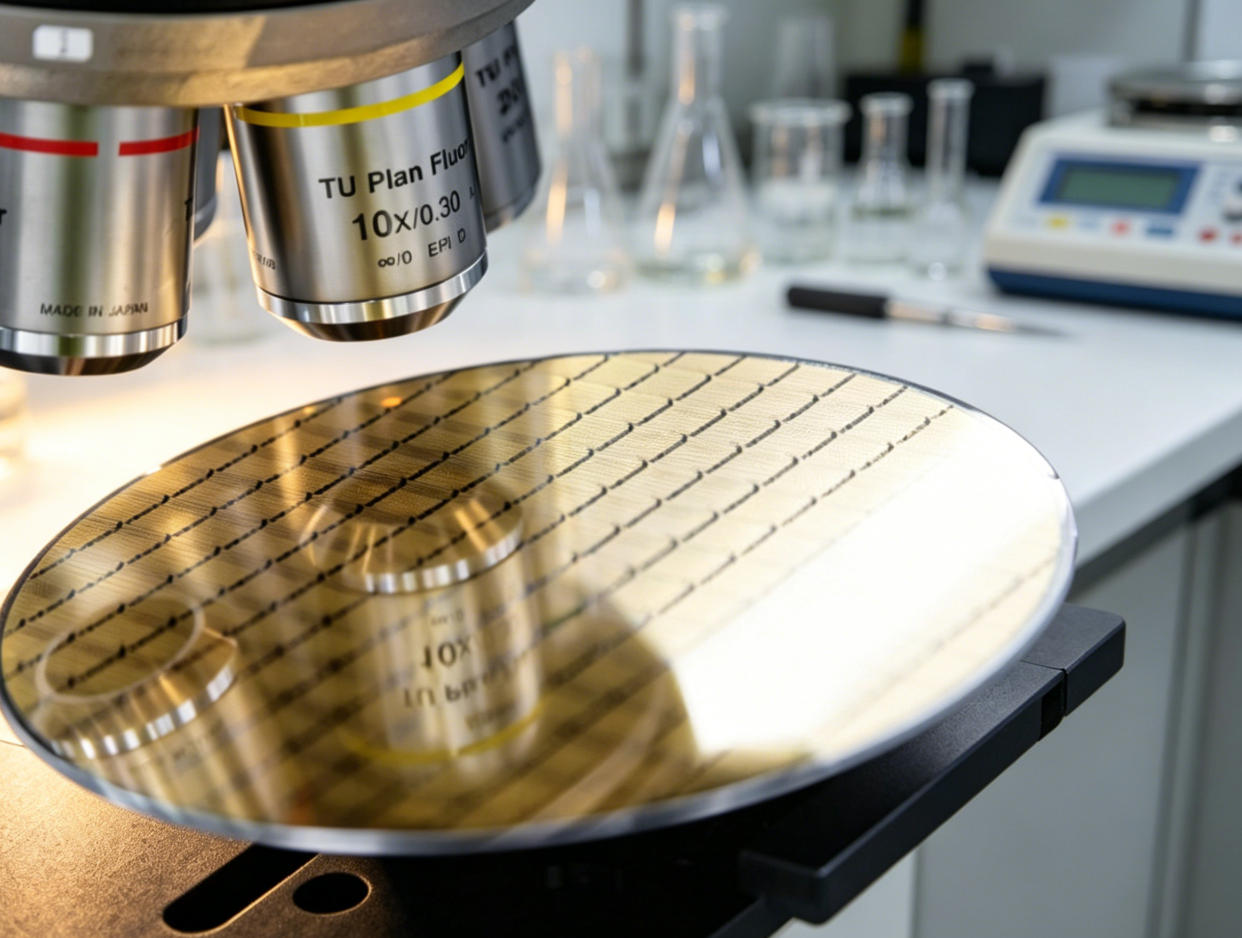
一、为什么氮化镓(GaN)被称为第三代半导体核心材料?
氮化镓属于第三代半导体(宽禁带材料),其核心参数决定了它在功率与高频领域的统治力:
| 参数 | GaN | Si | 影响 |
|---|
| 禁带宽度 Eg | 3.4 eV | 1.1 eV | 更耐高温、低漏电 |
| 临界击穿场 | ~3.3 MV/cm | ~0.3 MV/cm | 支持更高电压 |
| 电子迁移率 | 高 | 中 | 高频性能更好 |
| 饱和漂移速度 | 高 | 较低 | 更快开关 |
👉 推导结果:
-
同等耐压下,GaN 器件可以做得更薄、更小
-
导通电阻 Ron,sp 显著降低(理论上可低一个数量级)
-
开关损耗(Eon/Eoff)显著下降
GaN 的优势不是“更快一点”,而是物理极限层面的代际差异
二、GaN-on-Si 和 HEMT 结构到底解决了什么关键技术问题?
英特尔方案基于:
GaN-on-Si(硅基氮化镓) + HEMT(高电子迁移率晶体管)
1. HEMT 的核心机制是什么?
GaN HEMT 利用异质结(AlGaN/GaN)形成二维电子气(2DEG)
特点:
-
无需掺杂 → 减少散射
-
电子迁移率极高
-
导通电阻极低
👉 结果:
-
高频(GHz 级)下仍能保持低损耗
-
非常适合射频与电源开关
2. 为什么选择 GaN-on-Si 而不是 GaN-on-SiC?
相比 GaN-on-SiC:
| 方案 | 优点 | 缺点 |
|---|
| GaN-on-SiC | 散热好、性能高 | 成本极高 |
| GaN-on-Si | 可上300mm产线、低成本 | 热导率较低 |
👉 核心逻辑:
-
不追求极限性能
-
而是追求CMOS兼容 + 大规模量产能力
三、19 微米超薄 GaN 芯粒意味着什么?为什么“薄”是关键?
1. 为什么功率芯片必须做得更薄?
传统功率器件受限于:
超薄化带来三大收益:
(1)如何降低寄生参数并提升开关速度?
(2)为什么超薄芯片更适合先进封装(Chiplet/3D封装)?
-
可适配:
-
Foveros / EMIB / 3D stacking
-
可直接贴近 CPU/GPU die
👉 本质:
电源首次具备“进入封装内部”的物理条件
(3)超薄结构如何改变散热路径与热管理设计?
-
热扩散路径缩短
-
支持:
-
背面散热(backside cooling)
-
微通道冷却
2. 19 μm 在行业中处于什么水平?
-
传统 GaN:>100 μm
-
先进水平:~50 μm
👉 19 μm:
四、为什么要把 GaN 功率器件和 CMOS 数字电路做在同一芯片上?
1. 传统电源架构存在哪些瓶颈?
问题:
-
信号路径长
-
控制延迟高
-
EMI 噪声严重
-
能量损耗增加
2. 单片集成(Monolithic Integration)难点在哪里?
英特尔方案:
关键挑战:
-
工艺温度不兼容
-
高压与低压隔离问题
-
开关噪声耦合干扰
👉 能实现说明:
已突破异构单片集成技术瓶颈
3. 单片集成能带来哪些架构级优势?
(1)为什么控制回路可以达到纳秒级响应?
-
距离极短
-
延迟极低
👉 支持更高开关频率(MHz级甚至更高)
(2)电源为什么开始“数字化”和“智能化”?
支持:
(3)为什么可以减少外围芯片和系统复杂度?
👉 本质:
电源从模拟系统 → 可编程数字系统
五、GaN 芯粒如何解决数据中心和 AI 算力的供电瓶颈?
1. 为什么电源成为 AI 服务器的性能瓶颈?
-
GPU 功耗:700W → 1000W+
-
供电路径长 → IR Drop
-
多级转换损耗严重
2. GaN Chiplet 如何改变供电架构?
(1)什么是负载点供电(Point-of-Load, POL)?
(2)为什么高频电源可以显著缩小体积?
-
频率 ↑ → 电感/电容 ↓
👉 电源模块可嵌入封装
(3)GaN 如何提升整体能效模型?
总效率:
提升路径:
👉 对数据中心是结构性降本
六、为什么 GaN 是 5G/6G 和毫米波通信的关键材料?
1. GaN 为什么能支持 200GHz 以上高频?
👉 支持:
2. 6G 对功率器件提出了哪些新要求?
👉 GaN 是少数可行方案之一
七、这项技术会如何改变半导体产业格局?
1. 哪三大技术趋势正在融合?
-
Chiplet 架构
-
宽禁带半导体(GaN/SiC)
-
异构集成
2. 英特尔在产业竞争中的位置在哪里?
对标方向:
-
台积电:先进封装
-
英飞凌/意法:功率器件
-
GaN 初创公司:电源
👉 英特尔优势:
八、这项 GaN 芯粒技术的本质突破到底是什么?
英特尔实现了 GaN 功率器件与 CMOS 数字控制的单片级融合,并通过超薄化使其进入先进封装体系,从而将电源升级为与计算芯片同等级的“芯粒组件”。
它代表三大跃迁:
-
材料:Si → GaN
-
架构:分立 → 单片集成
-
系统:板级供电 → 封装级供电